現(xiàn)代半導(dǎo)體制造的目標(biāo)是為便攜式產(chǎn)品開發(fā)具有越來越小和更薄封裝的電子設(shè)備,。實現(xiàn)這一目標(biāo)最重要的步驟之一是通過機械研磨工藝將加工后的硅晶片從背面減薄至 50μm?以下,。為了避免應(yīng)力和亞表面損傷,這對表面粗糙度要求非常高,,在最終研磨步驟中,,該粗糙度可能在 1 nm Ra 的范圍內(nèi)。
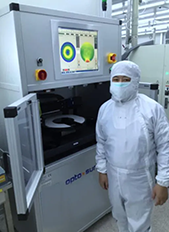
測量這一等級的表面粗糙度的常用方法是通過共聚焦顯微鏡 (CFM),、白光干涉儀 (WLI) 或原子力顯微鏡 (AFM) 進行單點或是劃線測量,。但這些儀器的缺點是對機械環(huán)境噪聲敏感,測量時間長,。
這里,,我們將介紹一種新型的散射光測量方法,該方法能夠在不到 30 秒的時間內(nèi)測量直徑300 mm整個晶圓表面,。除了粗糙度,,傳感器還同時測量翹曲、波紋度和缺陷,。同時將展現(xiàn)采用不同粒度研磨表面的測試結(jié)果分析,。
?
晶圓表面加工工藝過程
極小和高密度電子產(chǎn)品的趨勢需要先進的工藝來滿足設(shè)備的厚度和熱性能規(guī)格。這意味著處理后的硅晶片必須從其原始厚度超過 700 μm 減薄至 50 μm 或更小,。最常見且成本相對較低的減薄方法是通過機械去除殘余硅的背面研磨,。晶片固定在多孔真空吸盤上,IC(集成電路)面朝下,。砂輪的旋轉(zhuǎn)軸與晶片的旋轉(zhuǎn)軸離軸定位(距離是晶片的半徑),。卡盤呈略呈圓錐形的形狀,,以很小的傾斜度使晶片變形,,以確保砂輪在研磨過程中僅接觸晶片的一半。由于卡盤的旋轉(zhuǎn)和砂輪的同時旋轉(zhuǎn),,在晶片表面上產(chǎn)生了典型的螺旋劃痕圖案,。
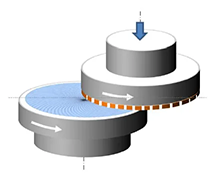
根據(jù)砂輪的粒度以及轉(zhuǎn)速和進給率等加工參數(shù),,這種機械沖擊是造成粗糙度、應(yīng)力和誘發(fā)亞表面損傷的原因,。因此,,現(xiàn)代晶圓磨床從粗砂輪開始,先是快速去除多余硅,,最后使用小粒度砂輪進行精細研磨,。當(dāng)減薄至 50 μm 以最大程度地減少次表面損傷和應(yīng)力時,,這個最終過程是絕對必要的,。表面粗糙度通常應(yīng)在 Ra<10 nm 甚至 1 nm 的范圍內(nèi),這對機械磨床來說是一個挑戰(zhàn),。晶圓表面的粗糙度是否太高或分布不均勻,,后續(xù)的引線鍵合、倒裝芯片組裝,、成型和測試等工藝步驟可能會因破裂而損壞薄芯片,。除了低表面粗糙度外,切割后模具的斷裂強度還取決于磨痕的方向,。
? 當(dāng)前標(biāo)準(zhǔn)測量方法的局限性是砂輪與其大量單刀刃的相互作用,,與硅表面經(jīng)歷不均勻磨損,特別是在應(yīng)用精細磨削程序時,,是一個相當(dāng)復(fù)雜的過程,。因此,不可能通過使用 AFM,、WLI 或 CFM 進行少量小區(qū)域粗糙度測量來預(yù)測研磨后整個晶片表面的質(zhì)量,。通常,這些標(biāo)準(zhǔn)測量方法中,, AFM 的情況下,,單次測量的評估面積在為 20 μm x 20 μm,在 CFM 或 WLI 的情況下為 160 μm x 160 μm,。每次測量大約需要 20 s-30 s,,并且需要抗振設(shè)備以避免受到環(huán)境機械噪聲的影響。? ? ?
OptoSurf?WaferMaster 300優(yōu)勢
? ?為了獲得整個晶圓表面的信息,,需要更快,、更穩(wěn)健的測量技術(shù)。散射光測量是唯一可以達到這些要求的方法,,Optosurf公司基于散射光測量技術(shù),,推出一款新的測量機器(WaferMaster 300),該系統(tǒng)使用散射光傳感器(如下圖)在不到 30 S的時間內(nèi)測量整個 300 mm晶片表面的粗糙度,。該系統(tǒng)使用 OS 500 散射光技術(shù),,該技術(shù)已在用于超導(dǎo)和醫(yī)療應(yīng)用的高質(zhì)量拋光金屬表面的表面測量中得到充分證明。由于傳感器的特殊設(shè)計,WaferMaster 還可以測量翹曲,、波紋度和缺陷,。

OptoSurf?WaferMaster 300測量原理
WaferMaster WM 300 是一種掃描設(shè)備,其中晶片位于卡盤上,,以大約 60 rpm 的速度旋轉(zhuǎn),,散射光傳感器垂直放置在表面上方 5 毫米處。每次旋轉(zhuǎn)后,,傳感器向晶片中心移動一小步,。根據(jù)設(shè)置,系統(tǒng)記錄 70,000-700,000 次單次粗糙度測量,,大約需要 1-10 分鐘,。同時,傳感器測量表面斜率,,這是翹曲和波紋度計算的基礎(chǔ),。

光源 (1) 以 0.9 mm 光斑尺寸 (2) 的 670 nm 紅色?LED 光斑幾乎垂直照射晶片表面。這是具有中等橫向分辨率的快速測量的標(biāo)準(zhǔn)方法,。為了獲得高橫向分辨率,,可以打開來自具有相同波長的激光源的另一個直徑為 0.03 mm?的光斑。光學(xué)器件 (3) 收集 32°角度范圍內(nèi)的散射光,,并將其引導(dǎo)至線性探測器 (4),。
? 帶有晶片 (6) 的卡盤在測量過程中連續(xù)旋轉(zhuǎn),傳感器從晶片邊緣線性移動到中心,。隨后,,傳感器測量整個晶圓表面,并在 30 秒內(nèi)以標(biāo)準(zhǔn)方式(0.9 毫米點)對 300 毫米晶圓進行約 70.000 次單次粗糙度測量,。非常重要的是傳感器的額外旋轉(zhuǎn) (7),,因為線性探測器應(yīng)始終垂直于磨痕定向以獲得最大粗糙度值。作為粗糙度參數(shù)Aq,,是通過計算散射光分布的方差得出.φi是單個散射角,,M是重心,p(φ)是分布曲線,。

與其他散射光傳感器相比,,該傳感器具有第二個評估通道,可通過傾斜角分析來測量翹曲和波紋度,。該傳感器測量鏡面光(表面的 0°部分)以及由表面微結(jié)構(gòu)產(chǎn)生的散射光,。這種設(shè)置的優(yōu)點是能夠使用散射光分布 (5) 的重心作為表面局部幾何變形的信號。了解表面的局部傾斜角度并以等距離(由編碼器信號創(chuàng)建)連續(xù)測量表面,,可以計算局部高度,,并通過整合所有角度,,計算表面的整個輪廓。
如下圖所示,,測量光束在 2 倍的局部傾斜角?下偏轉(zhuǎn),。因此,散射光分布在線性探測器上偏移了角度值 M,??梢酝ㄟ^使用第一個統(tǒng)計量來測量散射光分布曲線的矩。知道來自編碼器的步長Δx和光學(xué)元件的焦距,,就可以計算局部高度Δy并通過總結(jié)得出高度輪廓,。

Aq與Rdq、Ra關(guān)系
Aq 的優(yōu)點是與輪廓斜率參數(shù) Rdq 的密切關(guān)系,,它很好地描述了表面摩擦,。為了遵循將平均粗糙度 Ra 確定為粗糙度值的 Semi 標(biāo)準(zhǔn),,通過使用共聚焦顯微鏡對不同晶片進行比較測量,,將 Aq 參數(shù)與 Ra 相關(guān)聯(lián)。由于磨削表面振幅分布的隨機特性,,即使在使用不同粒度的砂輪時,,Aq 和 Ra 之間也有相當(dāng)好的相關(guān)性。但應(yīng)該考慮到 Aq 是一個更通用的參數(shù),,因為它對剖面的垂直和橫向結(jié)構(gòu)都有反應(yīng),,而 Ra 只測量平均垂直高度。Aq 的這種特性對于表征芯片強度可能很有趣,,并且應(yīng)該在未來進行更詳細的研究,。
相關(guān)性測量 Ra (nm) = f( Aq)
在不同的區(qū)域上研究了幾個晶片,磨粒尺寸從 #2000 到 #8000,。此外,,還測量了 Ra 值<1nm 的 CMP 拋光晶片以檢查系統(tǒng)的準(zhǔn)確性。為了計算 Ra 值,,WaferMaster 機器中使用了擬合的相關(guān)方程,。

測量結(jié)果展示及分析
傳感器測量散射光粗糙度值 Aq、宏觀傾斜角 M(從中計算翹曲和波紋度)和強度 I,。I 值與從裸晶圓散射光測量系統(tǒng)已知的 TIS 值相關(guān),。在粗糙度圖上,顏色顯示高和低粗糙度區(qū)域,。光學(xué)粗糙度值A(chǔ)q是散射光分布曲線的統(tǒng)計值(方差),。基于與已知 Ra 值的相關(guān)性,,Aq 可以轉(zhuǎn)換為 Ra,。只要加工過程不變,,這是有效的。翹曲計算基于撓度法,,其中主要值是傾斜角,。波紋度由高斯濾波器技術(shù) (ISO 16610) 的翹曲導(dǎo)出。


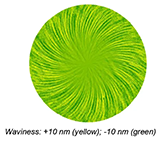

在 300 mm晶圓的 75 mm半徑 (360°) 的圓周上進行輪廓測量
在下圖所示,,顯示了 3 個晶片的粗糙度結(jié)果,,每個晶片的尺寸為 300 mm。它們都用相同的砂輪(粒度#4000)磨削,,但使用不同的磨床,。在 25 秒內(nèi)用 0.9 毫米的光斑總共進行了 40,000 次測量。除了平均粗糙度值的差異外,,它還特別表明機器確實留下了自己的特征模式,。詳細分析磨削參數(shù)(如進給率、卡盤幾何形狀,、旋轉(zhuǎn)速度等)的解釋可能會很有趣,。

使用相同砂輪(#4000)
但不同的磨床測量 300 mm 晶片的粗糙度
在下圖中可以看到同時測量 200 mm背面研磨晶片的粗糙度、形狀(翹曲)和波紋度的示例,。雖然砂輪的粒度也是 #4000,,但平均 Ra 值要高一些。從磨痕圖案可以看出,,旋轉(zhuǎn)是逆時針方向,,從左到右改變方向。翹曲相當(dāng)高,,因為沒有使用真空,。通過應(yīng)用 50 階高通濾波器計算波紋度。過濾器在圓周上工作,,這意味著中心區(qū)域比邊緣和中間區(qū)域過濾得更強烈,。將來會使用不同的過濾方法。波紋結(jié)構(gòu)遵循粗糙模式,,但也可見一些從左到右疊加的弱線狀條紋,。

背面研磨 200 mm晶元。
左:粗糙度 Ra,,中:翹曲,,右:波紋度
? ?這些條紋在下面的測量中更為突出,這是另一個 200 mm晶片但用 #2000 砂輪研磨的結(jié)果,。有趣的不是由較粗的砂輪引起的更高的粗糙度,,而是這里的條紋比磨痕的波紋圖案更突出。從 A 到 B 評估的峰谷高度超過 1 μm,,大約是磨痕波紋輪廓高度的 10 倍,。

使用 #2000 粒度砂輪研磨的晶片
粗糙度 Ra(左)和波紋度圖(右)
? ?線狀條紋可能是由之前的線鋸過程造成的,,在研磨過程后并沒有消失。這可能會發(fā)生,,因為在研磨過程中晶片通過真空固定在卡盤上,,這使得表面暫時平坦。當(dāng)晶片在研磨過程后被釋放時,,波紋結(jié)構(gòu)恢復(fù),。此外,如果卡盤沒有很好地清潔,,同樣的特性會產(chǎn)生凸起和凹坑,。凹痕的示例如下圖所示。300 mm拋光晶片的波紋度圖覆蓋有 2 個較大的凹痕和一些較小的凹痕,。通過使用 0.03 毫米傳感器,,可以用更高的局部分辨率再次測量較大的凹坑,并在 3D 地圖中表示出來,。寬度在 mm 范圍內(nèi),,而深度不超過 1 μm。
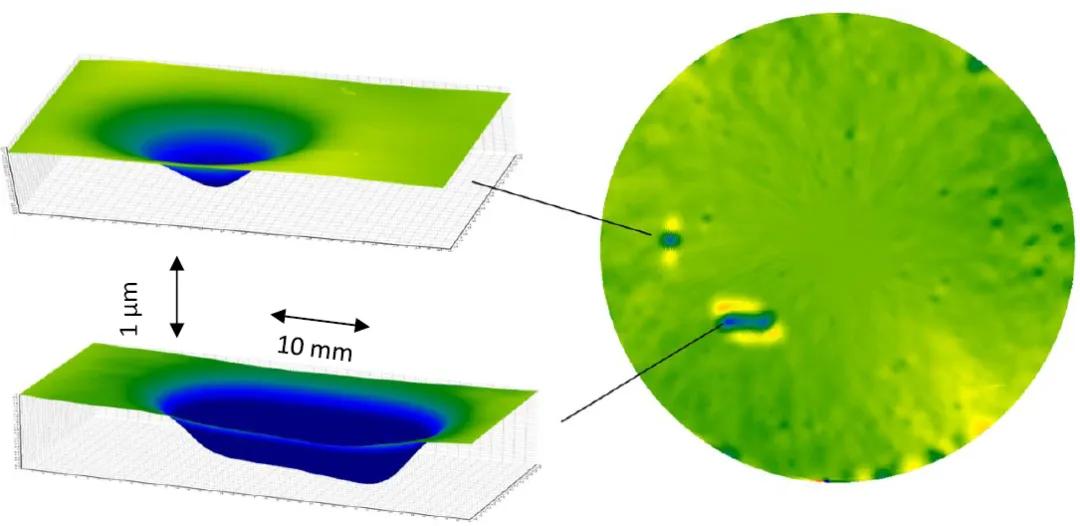
300 mm拋光晶元,,帶有凹痕(右 )
具有 0.03 mm 測量點的 3D 表示的高分辨率測量(左 )
高分辨率測量的另一個例子可以在下圖中看到,。這些測量是使用覆蓋 40 mm x 20 mm區(qū)域的 x/y 掃描模塊完成的,,也使用 0.03 毫米的小光斑尺寸,。測量值代表波紋結(jié)構(gòu)(應(yīng)用 25 階高通濾波器后)。平均粗糙度為 5 nm Ra,。在該部分的中心附近可以看到另一個凹痕,。選定的輪廓 (a) 顯示了峰谷高度約為 30 nm 的一般波紋度。重復(fù)性測量表明可以解析 1 nm 高度的結(jié)構(gòu),。

以高橫向分辨率(0.03 毫米光斑)測量的精細研磨硅晶片表面
左:20 mm x 40 mm區(qū)域波紋度測量和輪廓,。
右:相同的區(qū)域,但在凹痕上選擇輪廓,。
這使得 WaferMaster 更有趣地用于評估納米形貌結(jié)構(gòu),,以測量 CMP 工藝后的平面化質(zhì)量。此外,,從 3D 圖形中可以看出,,小點能夠檢測到單個缺陷(右側(cè)的紅色峰值),并且必須調(diào)查最低缺陷的極限是多少,。當(dāng)然,,它無法與更強大的散射光系統(tǒng)相抗衡,特別是為前端行業(yè)的小缺陷檢測而設(shè)計,,但在后端流程中使用此功能就足夠了,。
?
結(jié)論
本應(yīng)用案例中,,提出了一種新的散射光傳感器技術(shù)來測量晶片表面,特別是在背面研磨領(lǐng)域,。該傳感器通過評估散射光分布的方差 (Aq) 結(jié)合表面粗糙度測量,,并另外使用偏轉(zhuǎn)法來評估形狀(翹曲)和波紋度。Ra 評估基于使用共聚焦顯微鏡的相關(guān)性測量,??梢宰C明粗糙度測量的靈敏度下降到 Ra = 1 nm,精度為 0.1 nm,。這種技術(shù)的優(yōu)勢在于速度(整個 300 mm晶元掃描為 25 s)和對環(huán)境機械噪聲的不敏感性,。粗糙度、翹曲和波紋度的全區(qū)域表示功能為表征和改進磨削工藝以及從邊緣區(qū)域到中心完全檢查質(zhì)量開辟了新的可能性,。
根據(jù)封裝設(shè)計和背面研磨后工藝的敏感性,,邊緣到中心和沿圓周的粗糙度差異以及強烈的翹曲、波紋和缺陷會影響最終的功能和性能,。分離的芯片,。模具破損直接取決于粗糙度,特別是磨痕方向,。因此,,對背面研磨質(zhì)量的快速和連續(xù)測量有助于提高后端工藝的產(chǎn)量。